Technologie SKiiP® pro nízký kontaktní tepelný odpor a stálost
| Technologie SKiiP® pro nízký kontaktní tepelný odpor a stálost Aseem Wahi, SEMIKRON International Technologie SKiiP®, založená na tepelném přítlačném systému, zjednodušuje vývoj kompaktních a robustních výkonových modulů. Tato technologie zaručuje nízký tepelný odpor a vynikající stálost při tepelném cyklování. Montážní a kontaktní technologie používané ve výkonových modulech určují jejich cenu, spolehlivost a elektrické i teplotní možnosti. Montážní a kontaktní koncepce – tzv. technologie SKiiP®, vána již patnáct let v širokém rozsahu aplikací a výkonů. Vývoj čipů s vysokou proudovou hustotou, nových aplikací s vyššími požadavky na okolní teplotu a stálost (např. aplikace v hybridních vozidlech) stejně jako nové „zelené“ normy vyžadují úpravy a vylepšení montážní a kontaktní technologie. Technologie SKiiP® přítlačného systému V principu existují dva typy výkonových modulů, a to:
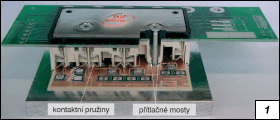 Obr. 1. Průřez modulem MiniSKiiP® 3 s přítlačnými mosty a kontaktními pružinami U obou typů se křemíkové čipy pájejí na laminovaný keramický substrát (DCB), který zajišťuje elektrickou izolaci. Ve většině případů je tento keramický substrát přiletován na měděnou základovou desku. Základová deska zaručuje mechanickou stabilitu a zlepšuje šíření tepla a tím zaručuje dobrý tepelný kontakt s chladičem. Všeobecně je modul upevněn na chladič šrouby, umístěnými na obvodu modulu. U malých modulů v nízké výkonové kategorii, tj. modulů s malým ztrátovým výkonem, je možné odstranit základovou desku, jelikož není absolutně nutná pro jeho funkci. Hlavním důvodem pro její odstranění je cena, avšak základní mechanický návrh modulu je zachován. Moduly pro velké výkony nemohou být takto navrženy, protože větší DCB mají sklon ke kroucení, pokud nemají podporu v základové desce; to vede k nerovnoměrnému kontaktu s chladičem a ke vzniku oblastí přehřátí. Technologie SKiiP® eliminuje problém kroucení, vznik oblastí přehřátí a zvyšuje výkonovou hustotu. Místo odstraněné základové desky je použit integrovaný přítlačný systém v modulu, který přitlačuje DCB k chladiči na několika rovnoměrně rozložených bodech.  Obr. 2. Graf rozložení přítlaku pro MiniSKiiP®3 s termopastou 50 µm na hliníkovém chladiči V malých modulech, jako je SEMITOP® nebo modul MiniSKiiP®, je přítlak šroubu přenášen na DCB pomocí přítlačných sloupů, které jsou součástí pouzdra. V tomto případě pouzdro zastává funkci přenosu přítlačné síly. U velkých modulů, jako je např. SKiiP® 2/3 nebo SKAI™, vytváří přítlak integrované přítlačné desky a pružiny. Ve většině případů byly také odstraněny pájené elektrické kontakty a kontakty pro výkonové a řídicí vývody jsou tvořeny pružinami, které rovněž fungují jako přítlačné body DCB. Na obr. 1 je průřez modulem MiniSKiiP® 3. Jsou zde ilustrovány přítlačné mosty okolo hrany DCB a okolo montážních šroubů a kontaktní pružiny. Na obr. 2 je graficky znázorněno rozložení přítlaku pro MiniSKiiP® 3. Podle předpokladu je největší přítlak okolo dvou montážních šroubů (dómy). Velmi homogenní přítlak lze však vidět v celé ploše modulu; to zaručuje velmi dobrý kontakt s chladičem. Tepelný kontakt s chladičem Typicky je použita tepelně vodivá pasta pro tepelný kontakt modulu a chladiče. Tato vrstva pro malou tepelnou vodivost pasty v porovnání s kovy představuje hlavní část tepelného odporu mezi čipem a chladičem. Tab. 1. Vypočítaný tepelný odpor modulu se základovou deskou
Tab. 2. Vypočítaný tepelný odpor modulu s technologií SKiiP®
Základová deska modulů je prohnutá, aby byl kompenzován bimetalický efekt mezi základovou deskou a DCB. Společně s pozicí montážních šroubů, umístěných na okraji modulu, to vede ke vzniku relativně velkých mezer pod základovou deskou. Pro překlenutí těchto mezer je nutné použít vrstvu termopasty o tloušťce 100 µm. Na moduly s technologií SKiiP® může být díky větší flexibilitě keramické vrstvy a distribuovanému přítlaku použita velmi slabá vrstva (25 až 50 Tento rozdíl má podstatný vliv na tepelný odpor mezi čipem a chladičem. V tab. 1 a tab. 2 jsou uvedeny standardní vrstvy, jejich tloušťky a koeficienty tepelné vodivosti v konvenčním modulu se základovou deskou a modulu s technologií SKiiP®. 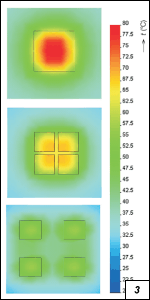 Obr. 3. Simulace maximální teploty čipu v modulu s technologií SKiiP® bez základové desky Vypočítaný celkový tepelný odpor je třeba považovat pouze za orientační, neboť nebyl brán v úvahu např. efekt šíření tepla v základové desce. Na základě toho lze učinit závěr, že tenčí vrstva termopasty a odstranění základové desky zlepší tepelný odpor u modulu s technologií SKiiP® o více než 40 %. Šíření tepla Důležitou funkcí, kterou zastává měděná základová deska, je šíření tepla. K šíření tepla přispívá svou velmi dobrou tepelnou vodivostí, čímž zvětšuje celkovou efektivní plochu pro přenos tepla, a tudíž vede k lepší teplotní vodivosti a snižuje tepelný odpor. Jako kompenzaci této nevýhody efektu šíření tepla používá SEMIKRON u modulů bez základové desky menší paralelně spojené čipy místo jednoho velkého čipu. Na obr. 3 je ukázána redukce maximální teploty čipu pro případ jednoho čipu 12 × 12 mm v porovnání se čtyřmi paralelně spojenými čipy o stejné celkové ploše. Tepelný profil jednoho velkého čipu, který má nepříznivý vliv na životnost modulu, je odstraněn díky distribuci tepla na čtyři čipy. Tento nepříznivý teplotní efekt je rovněž eliminován specifickou vzdáleností čipů mezi sebou. Snížení maximální teploty čipu, která je závislá na vzdálenosti čipů, je více patrné u modulů bez základové desky, protože zde je minimální vzájemná vazba mezi čipy. 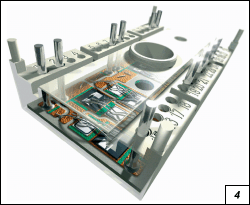 Obr. 4. Modul SEMITOP® s technologií SKiiP® Vezme-li se v úvahu příznivý teplotní efekt menších paralelně zapojených čipů a tenčí vrstva termopasty, je zřejmé, že moduly s technologií SKiiP® mají nižší tepelný odpor než ekvivalentní modul se základovou deskou. To znamená vyšší proudovou hustotu při stejné velikosti modulu, anebo menší, levnější modul při stejném výkonu. Spolehlivost a robustnost Další kladem technologie SKiiP® je její větší stabilita při výkonovém a tepelném cyklování. Když modul se základovou deskou dosáhne konce životnosti, pájený spoj mezi keramickým substrátem a základovou deskou se odtrhne v důsledku únavy tepelným cyklováním. Toto odtržení má za následek zvýšení tepelného odporu, přehřátí čipu a nakonec i odpadnutí vodivě pájeného přívodu. Čím jsou modul a pájené plochy větší, tím větší je pravděpodobnost defektu, neboť pájení velkých ploch je velmi obtížně kontrolovatelné. Pro zlepšení stability těchto pájených ploch jsou často používány pájky na bázi olova (na základě „bezolovnatých„ směrnic má být použití těchto pájek brzy zakázáno). V modulu bez základové desky jsou všechny tyto negativní faktory eliminovány. Navíc přítlačný kontaktní systém zaručuje stabilitu během celého životního cyklu modulu a je zlepšena celková spolehlivost a stálost. Skupiny produktů SEMITOP®, MiniSKiiP®, SKiiP®2/3 a SKAITM od společnosti SEMIKRON tvoří ucelenou výkonovou řadu modulů a systémů založených na technologii SKiiP®, která je vhodná v celém spektru aplikací v rozsahu výkonů od 0,55 kW do 1 MW. Tyto značkové výrobky se staly pojmem pro jejich kompaktnost, cenovou výhodnost a stálost. Další informace mohou zájemci získat na adrese: SEMIKRON s. r. o. | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||



